本文作者:
Lamoureux Violette,violette.lamoureux@st.com
Figarols Fran?ois,francois.figarols@st.com
Pic Nicolas,nicolas.pic@st.com
Vitrani Thomas,thomas.vitrani@st.com
摘要:就產品質量和生產環境的清潔度而言,半導體行業是一個要求很高的行業。金屬污染對芯片有害,所以應避免裸晶圓片上有金屬污染。本文的研究目的是交流解決裸硅圓片上金屬污染問題的經驗,介紹如何使用互補性測量方法檢測裸硅圓片上的少量金屬污染物并找出問題根源,解釋從多個不同的檢測方法中選擇適合方法的難度,以及用壽命測量技術檢測污染物對熱處理的依賴性。
I.前言
本文旨在解決硅襯底上的污染問題,將討論三種不同的金屬污染。第一個是鎳擴散,又稱為快速擴散物質[1],它是從晶圓片邊緣上的一個污點開始擴散的金屬污染。第二個是鉻污染,它是從Bulk體區內部擴散到初始氧化膜[2],并在晶圓片上形成了一層較厚的氧化物。第三個是晶圓片邊緣周圍的不銹鋼污染。本文的研究目的是根據金屬和圖1所示的污染特征找到污染的根源。
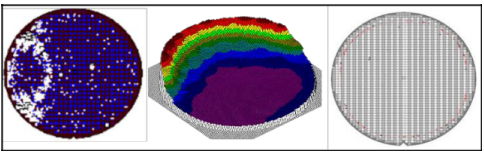
圖1. 三個金屬污染示例的映射圖。從左至右:鎳擴散的微掩膜缺陷圖;較厚的鉻氧化沉積層;晶圓片邊緣上不銹鋼污染電子晶圓片檢測(EWS)映射圖
AI.材料和方法
對于這些示例,我們是將多個不同的測量工具相互配合使用,才發現金屬污染物的存在。
全反射X射線熒光(TXRF)分析儀利用角度極小的X射線激勵拋光晶圓片表面,以獲得表面上的金屬污染物含量的映射圖[3]。
氣相分解電感耦合等離子體質譜儀(VPD-ICPMS)是通過電離使樣品離子化,并使用質譜儀分離離子,進行量化分析,以檢測含量極低的金屬和幾種非金屬[4]。
表面光電壓(SPV)方法是半導體表征測試所用的一種非接觸式技術,其原理是分析在表面電壓中照明引起的電荷。表面電荷和照明都可以測量表面電壓、氧化物厚度、界面陷阱密度、移動電荷、少數載流子擴散長度和生成壽命[5]。
微波檢測光電導衰減(μ-PCD)載流子壽命測量法也是一種非接觸式方法,在芯片制造過程中,用于晶圓來料檢查、質量控制和過程監測。該方法用激光脈沖照射硅氧化層,產生電子空穴對,以此表征載流子復合壽命。使用微波信號可以監測衰減載流子的濃度瞬變,詳見文獻[6]。
動態二次離子質譜(DSIMS)可以分析材料從表面到100微米深度或更深的元素組成。該方法使用連續聚焦的一次離子束濺射樣品表面,從被濺射脫落的離子化材料中提取部分樣品,放到雙聚焦質譜儀中,使用靜電和磁場根據離子的質荷比分離離子[7]。
KLA 2367檢查工具用于掃描缺陷后的特征,顯示缺陷程度和映射圖,檢測尺寸限制在0.16μm以上[8]。該缺陷檢測工具目前使用的是裸片對裸片比較方法。
橢偏法用于測量厚度,是一種無損測試方法,主要用于確定Bulk體區材料的光學指標和襯底上沉積或生長的薄層(小于或等于5 nm)的厚度均勻性,詳見文獻[9]。
最后,光致發光光譜技術是用來表征半導體的光學和電子特性。光致發光(PL)光譜技術是效果很好的研究半導體和半絕緣材料的本征和非本征電子結構的技術,有助于確定雜質含量,識別缺陷復合物,測量半導體的帶隙[10]。
BI.測量結果與討論
A.案例1:鎳,快速擴散物質
第一個案例是通過缺陷檢測設備發現的。在晶圓片有效區蝕刻后,許多晶圓片在左四分之一處出現相同的缺陷特征。這些晶圓片都是來自同一供應商的同一批次產品。
然后,從這批來料裸晶圓片中取出若干樣片,通過不同的測量技術進行分析。TXRF、VPD-ICPMS和SPV測量方法均未發現任何缺陷,所有圓片潔凈無瑕。
這個缺陷是在圓片有效區蝕刻后才檢測到的,因此,我們決定先對樣片進行快速熱氧化(RTO)處理,加熱到1,300 K左右,持續大約一分鐘,然后,使用SPV測量方法檢測,在晶圓片左側看到一小塊污染區[圖2]。
然后,將晶圓片置于熔爐中加熱到更高的溫度(1,100 K,5個小時)。在SPV和μPCD(條件:1,300 K,2小時)儀器上觀察到與缺陷檢測設備發現的完全相同的特征 [圖 3]。
使用VPD-ICPMS測量方法發現了污染成分。如圖4所示,在熱處理后,測量晶圓上的六個點:三個在晶圓的右側(點1、2和3),三個在左側(點4、5和6)。右側的三個測量點沒有污染,左側的中心點(點5)的鎳含量約18x1010 at /cm2。左側部分的其他兩個位置(點4和6)無法測量,因為,液滴實際上已經丟失,這是晶圓片表面高粗糙度的特征,與造成堆層缺陷的鎳污染吻合。
最后,在斜面上進行VPD-ICPMS測量,結果表明,污染物來自晶圓的斜面,而不是邊緣。這些最終信息使供應商能夠找到晶圓與鎳構成的金屬物質的接觸位置。

圖2. 在RTO處理后的SPV映射
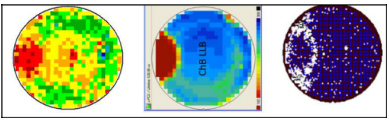
圖3.鎳特性映射圖(從左到右)與SPV、μPCD和缺陷檢測技術比較

圖4.測量點的VPD-ICPMS映射圖
這個案例讓我們看到,鎳在高溫下快速擴散,并且相同測量方法在加熱前后的測量結果完全不同。此外,它強調了一個事實,即一種測量方法不足以識別問題的根本原因,因此需要多個不同的測量方法配合使用。
B. 案例2:較厚的鉻氧化物沉積
這個案例的突出問題是直列初始氧化物厚度范圍超出控制范圍,高達控制限值的四倍,較厚的氧化物不是同質,但是位于晶圓片區頂部與缺口相對。當用TXRF的掃頻模式測量該晶圓片時,在同一晶圓片區域上檢測到的是鉻污染物,而不是較高的氧化物厚度[圖5]。這種在硅氧化過程中發生鉻擴散,因雜質而導致氧化層過厚,在文獻[2]中有論述。
VPD-ICPMS和TXRF測量表明,鉻污染只有在初始氧化后才可以測量到,而來料晶圓上則沒有檢測到。裸晶圓片的DSIMS配置文件突出了參考晶圓片與不良晶錠上切下的晶圓片之間的差異。在晶圓片背面,可以觀察到在整個LTO層(0到300 nm)和多晶硅層(800 nm)上有鉻污染,如圖6所示,但Bulk體區和正面沒有鉻污染。
在初始氧化后,觀察到從正面表面向下至100 nm深度存在鉻,在背面表面和1500 nm深度存在鉻[圖7]。

圖5. 從左到右:初始氧化物厚度映射圖和鉻TXRF映射圖。

圖6.來料受污染晶圓晶背面的DSIMS測量結果
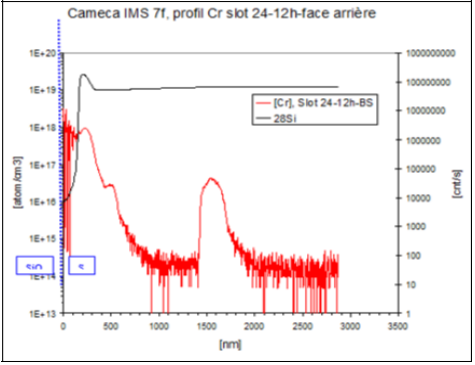
圖7.初始氧化后受污染晶圓背面的DSIMS測量結果。
在氧化物厚度0.8到1 nm的晶圓片上做進一步的VPD-ICPMS和TXRF測量,與0.15 nm厚度參考值對比。在TXRF掃頻模式下,受污染晶圓片上的平均鉻含量在13-15x1010 at /cm2之間,而且特征映射圖清晰。在五個不同的點進行VPD-ICPMS測量,如圖8所示,點1的鉻含量最高為88x1010 at/cm2,點2的鉻含量為20x1010 at /cm2,點3的含量為5.5x1010 at/cm2 和點 4和5低于檢測限值,約為0.7x1010 at/cm2。
然后進行了多種不同的測試,以測量在初始氧化熔爐內或在初始氧化物脫氧濕法清洗臺內可能發生的交叉污染。在這兩個測試過程中,被污染的晶圓片依次放置在兩個未污染的晶圓片之間,如圖9所示。
測試結果顯示,在熔爐中可見交叉污染。在VPD-ICPMS上測量未污染晶圓片,鉻含量約為4x1010 at /cm2,被污染晶圓片的鉻含量約為25x1010 at /cm2。 在濕法清洗臺上未觀察到交叉污染。

圖8.測量點的VPD-ICPMS映射圖
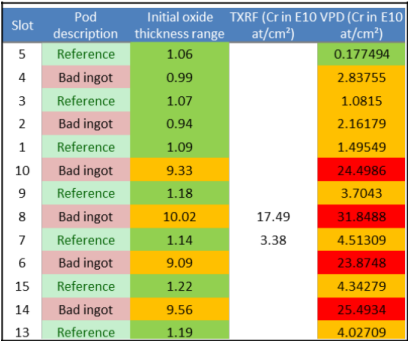
圖9.初始氧化熔爐內的交叉污染評估
為了驗證污染物是否可以去除,先將一些初始氧化晶圓脫氧,然后重新氧化。測試結果良好,鉻含量為1.15x1010 at /cm2,參考數值為0.25x1010 at /cm2。
最后,對一些晶圓片進行重新氧化處理,在HV氧化和隧道氧化后,再未檢測到任何污染物。因此,鉻污染對芯片來說并不是致命的。
所有這些實驗使我們能夠找到污染的來源。在沉積過程中,大量Cr被摻入LTO中。測試排除了很多假定污染物是因為元器件逐漸老化而從工藝腔體或馬弗爐排出的情況。這種情況可以使鉻擴散到晶圓表面,詳見文獻[2]。
C.案例3:晶圓片邊緣被不銹鋼污染
第三個案例是在晶圓電子檢測(EWS)期間發現的。 所有晶圓都來自同一供應商的同一晶錠。
檢測裸晶圓片的斜面,VPD-ICPMS測試只測到Cu和Al,而在晶圓的有效面上沒有測得任何金屬物質。經過第一道熱處理(快速熱處理(RTP))工序后,在裸片有效面上,除大量的鋁、鈦、鉻和銅外,仍然沒有測量到任何其他物質。參考晶圓片僅顯示有相同含量的鋁金屬。
在RTP熱處理后進行SPV測量,疑似晶圓片的缺陷特征非常清晰,而且在熔爐處理后變得更加清晰[圖10]。在DSIMS分析期間,未觀察到厚度測量或μPCD測量在RTP后受到任何影響,也未觀察到Epi/Si界面中存在金屬污染。
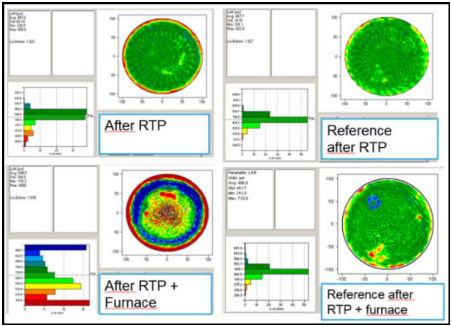
圖10.在RTP之后(圖頂部)和在RTP和熔爐處理后(圖底部),受污染的晶圓(左側)和參考樣片(右側)的SPV映射圖。
相反,在RTP和熔爐工序后,用光致發光方法測量裸晶圓片,測試結果良好。在晶圓的左右邊緣可見一些缺陷,凹口在底部。在熱處理后,在受污染的晶錠上看到了環狀特征。在光致發光圖與缺陷率映射圖疊加后,可以看到,環狀特征的直徑與缺陷率映射圖的直徑不完全相同,這可能有多種原因,例如,表面電荷或鈍化[圖11]。
最終,供應商成功找到了缺陷的根源并重現了問題,原來是上產線上的一顆螺絲錯位,刮擦到晶圓片的正面。在受影響的晶圓片上進行了五次VPD-ICPMS測量,在五個半徑不同圓環上收集污染物。第一次測量是在以晶圓片為中心的0到60毫米半徑的圓環上,然后,半徑依次是60到70毫米,80到90毫米,最后是90到100毫米(晶圓片的邊緣)。在0到90mm圓環上沒有測量到污染物。然而,在距邊緣最近的圓環上測量到鈦、鉻、鐵、鎳、鈷、銅和鉬,這與缺陷的根源相關。
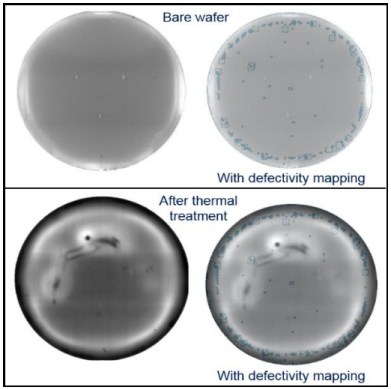
圖11.受污染的裸晶圓片的光致發光圖(左側)及其與缺陷率圖的疊加圖(右側),熱處理后的受污染的裸晶圓片的光致發光圖(左側)及其與缺陷率圖的疊加圖(右側)。
IV.結論
壽命測試和直接金屬污染測量是互補性技術,應配合使用。需要記住的是,在檢測和確定金屬污染時,沒有完美的測量技術,每種情況都是獨特的。
這些特定案例表明,為檢測一個問題選用不同的技術不是易事,用壽命測試技術檢測污染物依賴熱處理。實際上,在裸晶圓片上,任何SPV、TXRF或VPD-ICPMS方法都無法檢測到第一種情況的鎳污染和第二種情況的鉻污染。僅在對晶圓片進行退火處理后,才發生鎳擴散,并且在SPV上可見,并且僅在初始氧化工序后,厚度測量才顯示出晶圓片上氧化物厚度不均勻。通過TXRF和VPD-ICPMS測量,可以將其表征為鉻,并且由于DSIMS分析,才發現其存在于晶圓片Bulk體區內部。
最后,對于第三種情況,在熱處理后,晶圓片邊緣的環狀污染物在SPV測量中變得明顯,但只有VPD-ICPMS方法和在晶圓片邊緣上收集的特定物質,才讓我們得出不銹鋼污染的結論。
參考文獻
[1]S. Dubois and S. Martinuzzi, “Metal impurities in multicrystalline silicon solar cells: comparison between fast and slow diffusers” in
Conference Record of the IEEE Photovoltaic Specialists Conference, May 2008.
[2]C. J. Hsiao, A. S. Teng, W. C. Chang, Y. Y. Chen, M. Y. Lee, Y. S.
Tsai, T. W. Lee, D. J. Lin, A. Dai and C. Y. Lu, “Investigation of
Chromium Contamination induced TDDB Degradation in
MOSFET” in IPFA 2013, p. 61-64.
[3]H. Aiginger, “Historical development and principles of total reflection X-ray fluorescence analysis (TXRF)” in Spectrochimica Acta Part B: Atomic Spectroscopy, 1991, Vol. 46, Issue 10, p. 1313-1321.
[4]M. Horn, “Applications of ICP-MS in semiconductor industry” in Fresenius J Anal Chem, 1999, 364 : 385–390.
[5]Dieter K Schroder, “Surface voltage and surface photovoltage: history, theory and applications” in Measurement Science and
Technology, 2001, Vol. 12, num. 3.
[6]J. H?rk?nen, E. Tuovinen, Z. Li, P. Luukka, E. Verbitskaya, V. Eremin, “Recombination lifetime characterization and mapping of silicon wafers and detectors using the microwave photoconductivity decay (μPCD) technique” in Materials Science in Cemiconductor
Processing, 2006, Vol. 9, Issues 1-3, p. 261-265.
[7]G. Teeter, “Dynamic Secondary Ion Mass Spectrometry” in Materials Science, NREL Transforming Energy.
[8]X. Luan, Y. Liu, B. Zhang, S. Wang, X. Niu, C. Wang, J. Wang,
“Investigation of the barrier slurry with better defect performance and facilitating post-CMP cleaning” in Microelectronic
Engineering, 2017, Vol 170, p. 21-28.
[9]F. Ferrieu, J.H. Lecat, “Characterization of thin films and materials used in semiconductor technology by spectroscopic ellipsometry” in
Characterisation of Thin Films and Coatings, 1988, Vol 164, p. 43-50.
[10]J.E. Toney, “Photoluminescence Spectroscopy” in Characterization of Materials, 2002
上一篇:芯片,5G全面開花,韓國半導體業悶聲發大財
下一篇:NXP CEO:半導體并購潮還沒晚
推薦閱讀
史海拾趣
Dino-Lite公司一直將產品質量視為企業的生命線。公司建立了嚴格的質量管理體系和檢測流程,確保每一臺出廠的產品都符合高標準的質量要求。同時,公司還注重售后服務體系的完善和優化,為客戶提供及時、專業的技術支持和解決方案。
正是這種對品質的執著追求和對客戶的真誠服務,讓Dino-Lite公司贏得了客戶的信賴和支持。許多客戶都成為了公司的忠實粉絲和長期合作伙伴。
請注意,以上故事是基于電子行業的一般情況和Dino-Lite公司可能的發展路徑進行虛構的,并不代表Dino-Lite公司的實際發展歷程。如需了解更多關于Dino-Lite公司的具體信息和發展故事,建議查閱相關新聞報道、公司官網或行業分析報告。
Baumer Electric Ag公司創立于1952年,初期主要專注于微動開關的生產。面對市場競爭的激烈,公司創始人Herbert Baumer憑借其敏銳的市場洞察力和堅定的決心,帶領團隊不斷研發新產品,提升技術水平。1960年,公司成功推出首個程序控制系列,標志著Baumer在電控生產流程監控和控制領域取得了重要突破。
1962年,赫爾穆特?維茨(Helmut Vietze)加入Baumer Electric Ag,成為一名模具制造工。他憑借出色的個人能力和工作表現,很快在公司中脫穎而出。1964年,公司創始人Herbert Baumer去世后,Helmut Vietze接管了管理層,并帶領公司走向新的發展階段。他的領導為公司注入了新的活力,推動了Baumer在技術和市場上的雙重突破。
在環保日益受到重視的今天,一家名為“綠源電子組裝”的公司積極響應國家號召,致力于推動綠色環保的產業發展。公司引進了一系列環保設備和材料,采用了低碳、節能的生產工藝和管理方式,實現了生產過程中的減排降耗。同時,綠源電子組裝還積極參與社會公益活動,倡導綠色消費理念,為行業的可持續發展貢獻了自己的力量。
CR Magnetics公司成立于1986年,自創立之初,公司便致力于提供高質量的傳感器、傳感器組件等系列產品。憑借創始人的遠見卓識和團隊的共同努力,CR Magnetics很快在電子行業中嶄露頭角。公司總部位于美國密蘇里州圣路易斯市,擁有先進的生產設施和倉庫,為產品的研發和生產提供了堅實的基礎。
如今的Cree已經成為寬帶隙半導體的創新者,專注于碳化硅和氮化鎵材料、功率和射頻應用的設備以及特種照明級LED產品的研發和生產。其產品在運輸、電源、逆變器和無線系統等領域有著廣泛的應用。同時,Cree的LED產品也專門用于室內和室外照明、電子標牌和信號以及視頻顯示器等。作為市場上領先的照明革新者與半導體制造商,Cree通過顯著提高固態照明、電力及通訊產品的能源效果來提升其價值,展現了其在電子行業中的卓越地位和創新實力。
|
EPM7096LI68和JTAG cable 連接好后. 使用MAXplus時 畫了電路圖,選擇programer時 提示Installed hardware does not support device type"EPM7096LI68-15. 使用Quartus時 Auto detect 不到JTAG chain. 請問 ...… 查看全部問答∨ |
|
|
給大家發一個實用電子線路(需要閱讀器的) 之前的三角波自己搞明白了,就刪了 [ 本帖最后由 240767265 于 2009-8-31 11:04 編輯 ]… 查看全部問答∨ |
請問各位高手,我在筆記本電腦的廣告上看到了ThinkPad電腦,感覺質量很不錯。看到ThinkPad筆記本上印刷著IBM標志。可是廣告上卻寫著:“A Product of lenovo”翻譯過來是“聯想產品”。那么ThinkPad到底是聯想的,還是IBM的?給我弄糊涂了,謝謝各 ...… 查看全部問答∨ |
|
我想用單片機來選擇一個電路的通斷,比如單片機的一個管腳輸出高電平,就讓其他電路引出的兩根引線連通,不能用繼電器,有沒有芯片可以處理這樣的任務?我沒學過電子技術,請大家幫幫我,看看怎么實現 我主要是想用單片機控制電腦的PC鍵盤。單片機 ...… 查看全部問答∨ |
今天遇到一個問題,if判斷,應該相等卻不能執行。程序如下:...char adFlag;...void main (void){...while(1){if(1 == adFlag){_DINT();if( max(svm1) > THMOVE ) //對svm特征值判斷,是為運動狀態{MoveFlag1 = 1;StillFlag1 = 0;}else{M ...… 查看全部問答∨ |
|
網絡購買 圖書館掃描的 ULK3 80M 掃描的還可以的惡 但不是網上的幾百兆高清 uvz格式 閱讀器一并發布 上傳太慢了 留下郵箱就可以了 這本書 我去年在多個嵌入式Linux超級群發了&n ...… 查看全部問答∨ |
本帖最后由 paulhyde 于 2014-9-15 09:05 編輯 希望大家資料免費共享!! 讓 技術 不再因為 芯幣 而苦惱!! AD603的資料 峰峰值檢測電路 本人用了這個方案,可以用!! 現在分享 ...… 查看全部問答∨ |












 E5CS-R1KJU-W
E5CS-R1KJU-W






 京公網安備 11010802033920號
京公網安備 11010802033920號